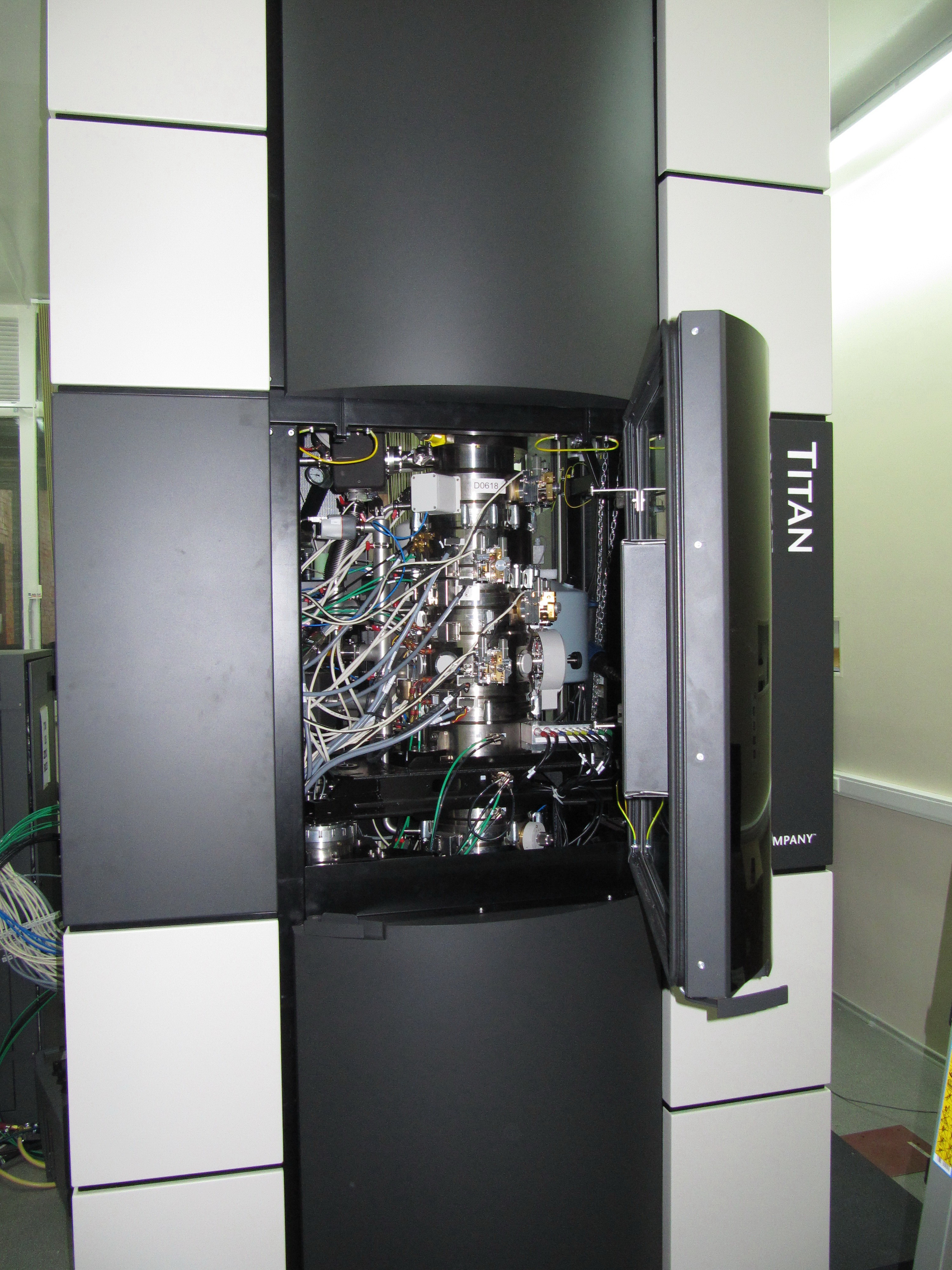
Высокоразрешающий электронный микроскоп Titan 80-300 — это следующее поколение просвечивающих микроскопов, работающих в диапазоне 80 — 300 кВ с возможностями коррекции сферической аберрации и монохроматичности. Удовлетворяющий всем требованиям по стабильности, производительности и гибкости, Титан обеспечивает разрешение на суб-ангстремном уровне и предлагает наилучшие технические характеристики в режимах TEM и STEM. Титан расширяет разрешающие возможности спектроскопии при измерении запрещенных энергетических зон и электронных свойств и позволяет получить четкие изображения границ раздела и наиболее полно интерпретировать полученные данные.
- Марка - Titan 80-300
- Производитель/страна - FEI, Нидерлады.
- Технические характеристики -
- Ускоряющее напряжение: 80-300 кВ;
- Источник электронов с полевой или термополевой эмиссией;
- Наличие энергетического фильтра и монохроматора (для прецизионного EELS анализа);
- Наличие корректора сферической аберрации линз;
- CCD камеры и детекторы для работы в режимах HREM, STEM, HAADF, EFTEM, CONVERGEN BEAM;
- EDX и EELS спектрометры;
- Разрешающая способность : STEM - 0.135 нм; HREM - 0.08 нм;
- Разрешение по энергиям при EELS анализе - менее 0,5 эВ;
- Местонахождение в ЦКП - Отделение высокоразрешающей электронной микроскопии, к. 103
- Год модернизации - 2012.
- Предоставляемые услуги:
- Исследования атомной структуры веществ методами высокоразрешающей просвечивающей электронной микроскопии с корректором сферических аберраций, включая исследования на просвет планарных структур и поперечных сечений.
- Проведение измерений линейных размеров элементов структур микро- и нанорельефа поверхности твердотельных материалов и биологических объектов в нанометровом диапазоне.
- Количественный анализ механических напряжений в гетероэпитаксиальных системах на основе обработки оцифрованных изображений высокоразрешающей электронной микроскопии.
- Наноструктурирование нелитографическими методами посредством in-situ управления процессами самоорганизации структуры поверхности кристаллов в сверхвысоковакууумных условиях.
- Используемые методики:
- Методика количественного размерно-морфологического анализа различных типов материалов и измерений характеристик электронной дифракционной картины в веществе с применением просвечивающего электронного микроскопа.
- Компьютерная методика количественного анализа механических напряжений в гетероэпитаксиальных системах на основе обработки оцифрованных картин высокоразрешающей электронной микроскопии.
- Методика компьютерного моделирования атомной структуры нонообъектов, кластерных и протяженных конфигураций дефектов структуры, границ раздела для построения теоретических высокоразрешающих электронно-микроскопических изображений и последующего сравнения с экспериментальными изображениями с целью получения достоверной информации об атомной структуре анализируемых объектов.
- Методика препарирования планарных кристаллических образцов для просвечивающей и высокоразрешающей электронной микроскопии, включающая химико-механическую полировку, химическое травление и термическое окисление.
- Методика изготовления образцов поперечного сечения, основанная на ионном травлении тонких механических срезов склеенных структур, для изучения пространственного распределения, морфологии и атомной структуры нанообъектов, протяженных дефектов, границ раздела методами просвечивающей электронной микроскопии.
- Оригинальная методика препарирования сложных химических соединений на основе А2В6 для просвечивающей и высокоразрешающей электронной микроскопии, позволяющая изготовление планарных и поперечных сечений на основе химико-механического утонения.






